錫山區(qū)標(biāo)準(zhǔn)集成電路服務(wù)熱線
集成度高低集成電路按集成度高低的不同可分為:SSIC 小規(guī)模集成電路(Small Scale Integrated circuits)MSIC 中規(guī)模集成電路(Medium Scale Integrated circuits)LSIC 大規(guī)模集成電路(Large Scale Integrated circuits)VLSIC 超大規(guī)模集成電路(Very Large Scale Integrated circuits)ULSIC特大規(guī)模集成電路(Ultra Large Scale Integrated circuits)GSIC 巨大規(guī)模集成電路也被稱作極大規(guī)模集成電路或超特大規(guī)模集成電路(Giga Scale Integration)。導(dǎo)電類型不同GSIC 巨大規(guī)模集成電路也被稱作極大規(guī)模集成電路或超特大規(guī)模集成電路(Giga Scale Integration)。錫山區(qū)標(biāo)準(zhǔn)集成電路服務(wù)熱線
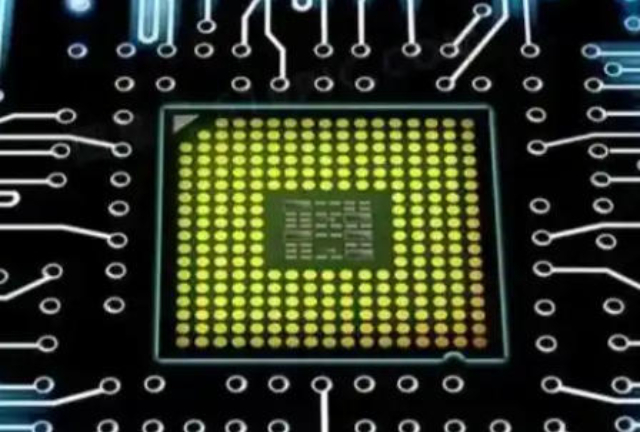
65、SOP(small Out-Line package)小外形封裝。表面貼裝型封裝之一,引腳從封裝兩側(cè)引出呈海鷗翼狀(L字形)。材料有塑料和陶瓷兩種。另外也叫SOL和DFP。SOP除了用于存儲(chǔ)器LSI外,也***用于規(guī)模不太大的ASSP等電路。在輸入輸出端子不超過10~40的領(lǐng)域,SOP是普及**廣的表面貼裝封裝。引腳中心距1.27mm,引腳數(shù)從8~44。另外,引腳中心距小于1.27mm的SOP也稱為SSOP;裝配高度不到1.27mm的SOP也稱為TSOP(見SSOP、TSOP)。還有一種帶有散熱片的SOP。66、SOW(Small Outline Package(Wide-Jype))寬體SOP。部分半導(dǎo)體廠家采用的名稱。濱湖區(qū)好的集成電路工廠直銷無引腳芯片載體。指陶瓷基板的四個(gè)側(cè)面只有電極接觸而無引腳的表面貼裝型封裝。

QUIP的別稱(見QUIP)。51、QUIP(quad in-line package)四列引腳直插式封裝。引腳從封裝兩個(gè)側(cè)面引出,每隔一根交錯(cuò)向下彎曲成四列。引腳中心距1.27mm,當(dāng)插入印刷基板時(shí),插入中心距就變成2.5mm。因此可用于標(biāo)準(zhǔn)印刷線路板。是比標(biāo)準(zhǔn)DIP更小的一種封裝。日本電氣公司在臺(tái)式計(jì)算機(jī)和家電產(chǎn)品等的微機(jī)芯片中采用了些種封裝。材料有陶瓷和塑料兩種。引腳數(shù)64。52、SDIP(shrink dual in-line package)收縮型DIP。插裝型封裝之一,形狀與DIP相同,但引腳中心距(1.778mm)小于DIP(2.54mm),
38、PLCC(plastic leaded chip carrier)帶引線的塑料芯片載體。表面貼裝型封裝之一。引腳從封裝的四個(gè)側(cè)面引出,呈丁字形,是塑料制品。美國德克薩斯儀器公司首先在64k位DRAM和256kDRAM中采用,90年代已經(jīng)普及用于邏輯LSI、DLD(或程邏輯器件電路。引腳中心距1.27mm,引腳數(shù)從18到84。J形引腳不易變形,比QFP容易操作,但焊接后的外觀檢查較為困難。PLCC與LCC(也稱QFN)相似。以前,兩者的區(qū)別*在于前者用塑料,后者用陶瓷。但現(xiàn)在已經(jīng)出現(xiàn)用陶瓷制作的J形引腳封裝和用塑料制作的無引腳封裝(標(biāo)記為塑料LCC、PC LP、P-LCC等),已經(jīng)無法分辨。為此,日本電子機(jī)械工業(yè)會(huì)于1988年決定,把從四側(cè)引出J形引腳的封裝稱為QFJ,把在四側(cè)帶有電極凸點(diǎn)的封裝稱為QFN(見QFJ和QFN)。模擬集成電路又稱線性電路,用來產(chǎn)生、放大和處理各種模擬信號(hào)(指幅度隨時(shí)間變化的信號(hào)。

13、DIP(dual tape carrier package)同上。日本電子機(jī)械工業(yè)會(huì)標(biāo)準(zhǔn)對DTCP 的命名(見DTCP)。14、FP(flat package)扁平封裝。表面貼裝型封裝之一。QFP或SOP(見QFP和SOP)的別稱。部分半導(dǎo)體廠家采用此名稱。15、flip-chip倒焊芯片。裸芯片封裝技術(shù)之一,在LSI芯片的電極區(qū)制作好金屬凸點(diǎn),然后把金屬凸點(diǎn)與印刷基板上的電極區(qū)進(jìn)行壓焊連接。封裝的占有面積基本上與芯片尺寸相同。是所有封裝技術(shù)中體積**小、**薄的一種。但如果基板的熱膨脹系數(shù)與LSI芯片不同,就會(huì)在接合處產(chǎn)生反應(yīng),從而影響連接的可靠性。因此必須用樹脂來加固LSI芯片,并使用熱膨脹系數(shù)基本相同的基板材料。當(dāng)今半導(dǎo)體工業(yè)大多數(shù)應(yīng)用的是基于硅的集成電路。江蘇節(jié)能集成電路廠家價(jià)格
表示帶散熱器的標(biāo)記。例如,HSOP表示帶散熱器的SOP。錫山區(qū)標(biāo)準(zhǔn)集成電路服務(wù)熱線
6、COB(chip on board)板上芯片封裝,是裸芯片貼裝技術(shù)之一,半導(dǎo)體芯片交接貼裝在印刷線路板上,芯片與基板的電氣連接用引線縫合方法實(shí)現(xiàn),芯片與基板的電氣連接用引線縫合方法實(shí)現(xiàn),并用樹脂覆蓋以確保可靠性。雖然COB是**簡單的裸芯片貼裝技術(shù),但它的封裝密度遠(yuǎn)不如TAB和倒片焊技術(shù)。7、DFP(dual flat package)雙側(cè)引腳扁平封裝。是SOP的別稱(見SOP)。以前曾有此稱法,80年代后期已基本上不用。8、DIC(dual in-line ceramic package)陶瓷DIP(含玻璃密封)的別稱(見DIP)錫山區(qū)標(biāo)準(zhǔn)集成電路服務(wù)熱線
無錫大嘉科技有限公司在同行業(yè)領(lǐng)域中,一直處在一個(gè)不斷銳意進(jìn)取,不斷制造創(chuàng)新的市場高度,多年以來致力于發(fā)展富有創(chuàng)新價(jià)值理念的產(chǎn)品標(biāo)準(zhǔn),在江蘇省等地區(qū)的汽摩及配件中始終保持良好的商業(yè)口碑,成績讓我們喜悅,但不會(huì)讓我們止步,殘酷的市場磨煉了我們堅(jiān)強(qiáng)不屈的意志,和諧溫馨的工作環(huán)境,富有營養(yǎng)的公司土壤滋養(yǎng)著我們不斷開拓創(chuàng)新,勇于進(jìn)取的無限潛力,大嘉科技有限公司供應(yīng)攜手大家一起走向共同輝煌的未來,回首過去,我們不會(huì)因?yàn)槿〉昧艘稽c(diǎn)點(diǎn)成績而沾沾自喜,相反的是面對競爭越來越激烈的市場氛圍,我們更要明確自己的不足,做好迎接新挑戰(zhàn)的準(zhǔn)備,要不畏困難,激流勇進(jìn),以一個(gè)更嶄新的精神面貌迎接大家,共同走向輝煌回來!
- 無錫名優(yōu)汽車連接器生產(chǎn)廠家 2025-12-19
- 錫山區(qū)節(jié)能汽車連接器廠家價(jià)格 2025-12-19
- 江陰質(zhì)量集成電路圖片 2025-12-19
- 蘇州名優(yōu)汽車連接器市價(jià) 2025-12-19
- 濱湖區(qū)好的汽車連接器圖片 2025-12-19
- 徐州好的集成電路廠家供應(yīng) 2025-12-19
- 錫山區(qū)質(zhì)量集成電路產(chǎn)品介紹 2025-12-19
- 蘇州好的汽車連接器廠家價(jià)格 2025-12-19
- 宜興質(zhì)量集成電路銷售方法 2025-12-19
- 惠山區(qū)常見汽車連接器圖片 2025-12-18
- 河南制冷劑型號(hào) 2025-12-19
- 合誠潤滑氟素脂適用溫度范圍 2025-12-19
- 崇川純電suv汽車報(bào)價(jià) 2025-12-19
- 無錫名優(yōu)汽車連接器生產(chǎn)廠家 2025-12-19
- 松江區(qū)好的五金交電圖片 2025-12-19
- 蕪湖正規(guī)輪廓度檢測價(jià)格 2025-12-19
- 福建哈佛車燈升級(jí)廠家 2025-12-19
- 浙江威格爾同步帶生產(chǎn)廠 2025-12-19
- 上海正規(guī)逆向工程誠信企業(yè) 2025-12-19
- 四川新型車燈注塑模具 2025-12-19